

氮化镓(GaN)作为新一代宽带隙半导体的代表,具有优越的物理特性,例如宽带隙(3.4 eV)、高击穿电场(~3.0 MV/cm)、高电子迁移率(1000 cm2/V·s)和低导通电阻。随着氢化物气相外延(HVPE)技术的发展,近年来高质量的氮化镓单晶衬底已经被制造出来并应用于半导体器件。氮化镓基材料在这些衬底上的同质外延生长可以有效地减少缺陷密度,提高器件性能。
到目前为止,大多数基于GaN的电力电子和光电器件都是在c面极性GaN材料上制造的。由于缺乏反转对称性,氮化镓晶体在c轴方向具有很强的极性,这导致了强烈的自发和压电极化。由于极化效应,在光电子器件中出现了一些挑战,如发光效率下降、存在绿光和黄光陷阱等。而半极性或非极性面的自发极化很弱或者不存在,在这些晶面上制作器件可以提供独特的材料和器件特性。如图1所示,垂直于c面的平面是非极性的(例如m面和a面),这些晶面上具有相同数量的Ga和N原子。非极性和半极性面有望通过减少量子约束斯塔克效应(QCSE)和提高铟的结合效率来提高LED在绿色光谱区域的效率。金属和GaN之间的电接触对所有类型的器件都起着关键作用。目前,关于非极性或半极性GaN上电学接触的研究数量有限,并且缺乏对半极性或非极性GaN单晶衬底上肖特基接触特性的分析与比较。
省科学院半导体研究所的研究人员详细探究了在a面、m面和s5面GaN衬底上制备的肖特基势垒二极管(SBDs)的电学性能差异及影响机制。结果显示GaN SBDs的势垒高度、开启电压、理想因子和反向漏电都和晶体取向有强烈的依赖性。在反向偏压下,由于GaN衬底的高载流子浓度,TFE模型在漏电流方面占主导地位。 通过变温I-V测试发现在所有的SBDs中都存在势垒不均匀性,m面和s5面的器件更明显。这与不同的极性、悬挂键的分布和表面的天然氧化物有关。根据XPS谱线分析数据,肖特基势垒不均匀性与表面的GaOx含量有明显的关系。因此,a面GaN具有最佳的材料表面特性,而m面和s5面则需要更多的表面清洁和预处理手段。该研究为GaN新型光电子器件的设计提供了新的视角。
相关研究成果发表在国际权威期刊《Journal of Alloys and Compounds》(中科院SCI材料科学二区Top期刊,2021年影响因子5.316),省科学院半导体研究所任远博士为论文第一作者,微纳加工平台主任刘宁炀博士为通讯作者。该研究工作得到了广东省重点领域研发计划项目,广东省科学院建设国内一流研究机构行动专项资金项目的支持。

图1. (a)a面、(b)m面和(c)s5面的GaN的原子排列。(d) 在GaN晶胞中三个晶面的示意图
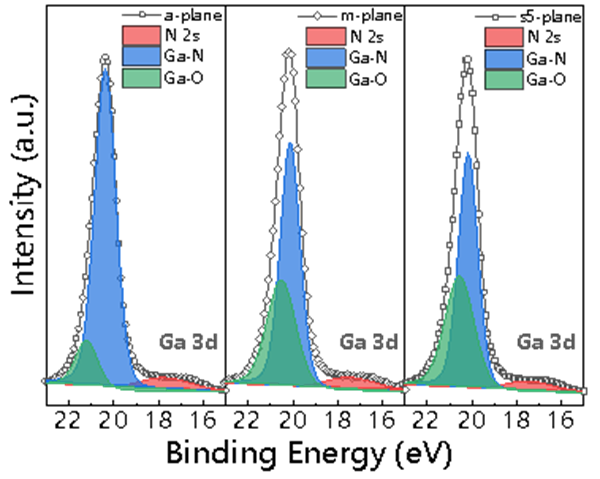
图2. a面、m面和s5面GaN单晶的XPS谱
论文链接:https://doi.org/10.1016/j.jallcom.2021.162817